分析分子線エピタキシー装置(Molecular Beam Epitaxy : MBE) “MBE大” (D6)

- FT-IR (Bruker Optics Vertex 70)
- RHEED-gun (Vieetech VE052)
- RHEED Image analysis system (K-space KSA400)
- Q-mass x2 (Spectra MONITORR; SRS RGA100)
- LEED-AES (OCI BDL-600IR)
- K-cell x3 (EPI)
- Multi(x3) E-gun (Vieetech)
- Sputter-gun (ULVAC-PHI USG3)
- Ion-source (SPECS IQE 12/38)
装置模式図
超高真空真空中に備えられたK-セル(x2)や電子ビーム蒸着源(x3)により、単原子層オーダーで蒸着原子を基板に堆積することが出来ます。
作製した試料の表面構造は高速反射電子線回折(RHEED)、低速電子線回折(LEED)により評価されます。
また、フーリエ変換赤外分光装置(FTIR)により基板表面吸着分子の高感度反射赤外(IRRAS)測定や偏光変調赤外分光(PMIR)、昇温脱離装置(TDS)脱離測定が可能です。
分析分子線エピタキシー装置 “Jr.” (D6)
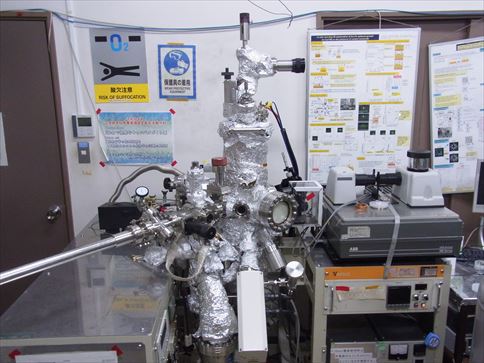
- FT-IR (Bomem MB100)
- RHEED-gun (Vieetech VE052)
- RHEED Image analysis system (K-space KSA400)
- Q-mass (Spectra MONITORR)
- E-gun x2 (Vieetech)
- Sputter-gun (ULVAC-PHI USG3)
- Arc-plasma gun (ULVAC ARL300)
装置模式図
小型のMBE装置です。清浄化のためのスパッタリング銃、電子ビーム蒸着源(x2)、RHEED, FTIR, アークプラズマ蒸発源が備え付けられています。
分析分子線エピタキシー装置 “B室NEDO” (D3)

- FT-IR (Bomen MB100)
- LEED (OCI BDL-400IR)
- Evaporation source x2 (AVC)
- Sputter-gun (Omegatoron OMI-0043CKE)
装置模式図
MBE装置です。清浄化のためのスパッタリング銃、電子ビーム蒸発源(x2)、FTIR、LEED等により表面物性評価が出来ます。モデル電極触媒の作製にも使用します。
超高真空アークプラズマ装着装置 “アークプラズマ” (A406)

- Arc-plasma gun x2 (ULVAC ARL300)
装置模式図
超高真空中にアークプラズマ蒸発源(x2)が備えられており、両者のシークエンス制御により任意の基板に組成制御した合金ナノ微粒子の作製が可能です。
超高真空走査トンネル顕微鏡(UHV-STM) “UHV-STM” (D3)

- UHV-STM (JEOL JSPM-4500S + SEINAN UHV-EC transfer rod)
- X-ray-gun (SPECS XR50)
- Electron energy analyser (SPECS PHOIBOS 100 MCD-5)
- LEED / Auger Spectrometers (OCI BDL 600IR)
- Evasporation source x2 (Beamtron)
- Low energy neutral ion gun (Omegatron OMI-0736ND)
装置模式図
超高真空中に備えられた走査トンネル顕微鏡(STM : Scanning Tunneling Microscope)により、固体表面構造を原子レベルで観察できます。分析室には低速化・中性化機能を備えたイオン銃、電子ビーム銃(x2)、LEED/AES、X線光電子分光(X-ray Photoelectron Spectroscopy : XPS)用の静電半球アナライザーとX線銃が装備されており、試料作製、電子線回折による表面構造の観察、光電子分光による電子状態評価、イオン散乱法による材料表面組成の評価がその場ですることができます。









