2005年
45nm世代LSI配線用の新合金を開発
- 2005年6月28日(NHK)、2005年6月29日(日経産業新聞、読売新聞、河北新報)、日経マイクロデバイス7月号
- 知能デバイス材料学専攻 小池 淳一 教授
45nm世代以降のLSI配線において、工程数が短縮できデバイス特性と信頼性をともに向上できる新規銅配線材料とそのプロセスの開発に成功した。配線材料に銅マンガン合金(CuMn合金)を用いることで、配線と層間絶縁膜との界面に極薄(2nm)バリア層を自己形成し、実際のデバイス配線構造において実証した。その結果、配線抵抗を純銅レベルまで低減できた。また、ビア底部にバリア層がないためビア抵抗が50%低減し、断線寿命が4倍以上向上した。
新しく開発された合金とプロセスを用いることによって、45nm対応の高性能・高信頼性配線が実現できるだけでなく、バリア層に高価な金属材料を用いる必要がないこと、バリア層形成工程を省略できること、現状のプロセス装置に適用可能であること、45nm以前の配線にも適用できること、などコスト的にも多くのメリットが期待できる。これによって微細化に伴う配線抵抗の上昇と配線不良の問題点が一気に解決でき、45nm世代の実用化が加速するとみられる。
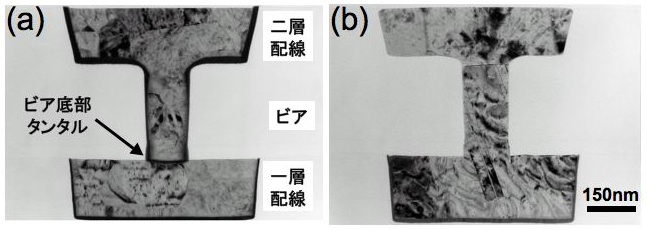
実際に作製したデュアルダマシン配線の断面構造。(a)Taをバリア層とした従来型配線。配線周辺の黒い部分がTaバリア層。一層と二層配線を接続するビアの底部にTaが存在するためビア抵抗が上昇し、プロセス中や動作中に断線を引き起こす原因となる。(b)自己形成バリア層による新型配線。配線周辺のバリア層は2nmであり、この倍率では可視化不能。ビア底部にバリアがないためビア抵抗が50%低減し、断線寿命が4倍以上向上した。

